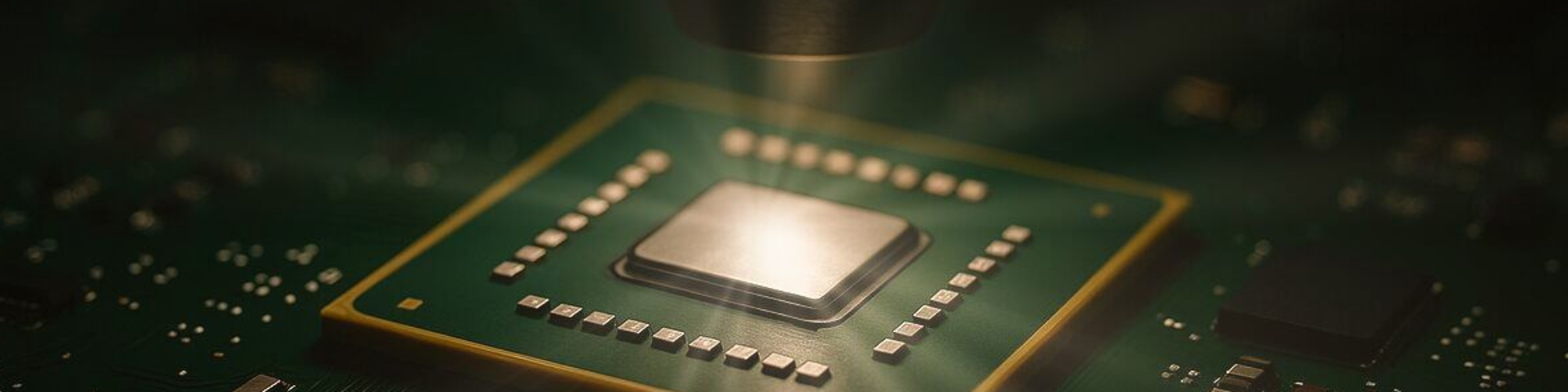
BGA ReworkBGA・基板リワーク・改造
BGAリワークとは
BGAリワークとは、完成基板上のBGAデバイスに対し専用のリワーク機にて部分加熱し、以下の作業を行うものです。
アイオン電子のBGAリワークは、共晶はもちろん、鉛フリーにも対応できます。
その他、お客様のご要望、基板の状態・症状に合わせた作業が可能です。
LGA、QFN、SON等、ICのリワークも対応可能です。
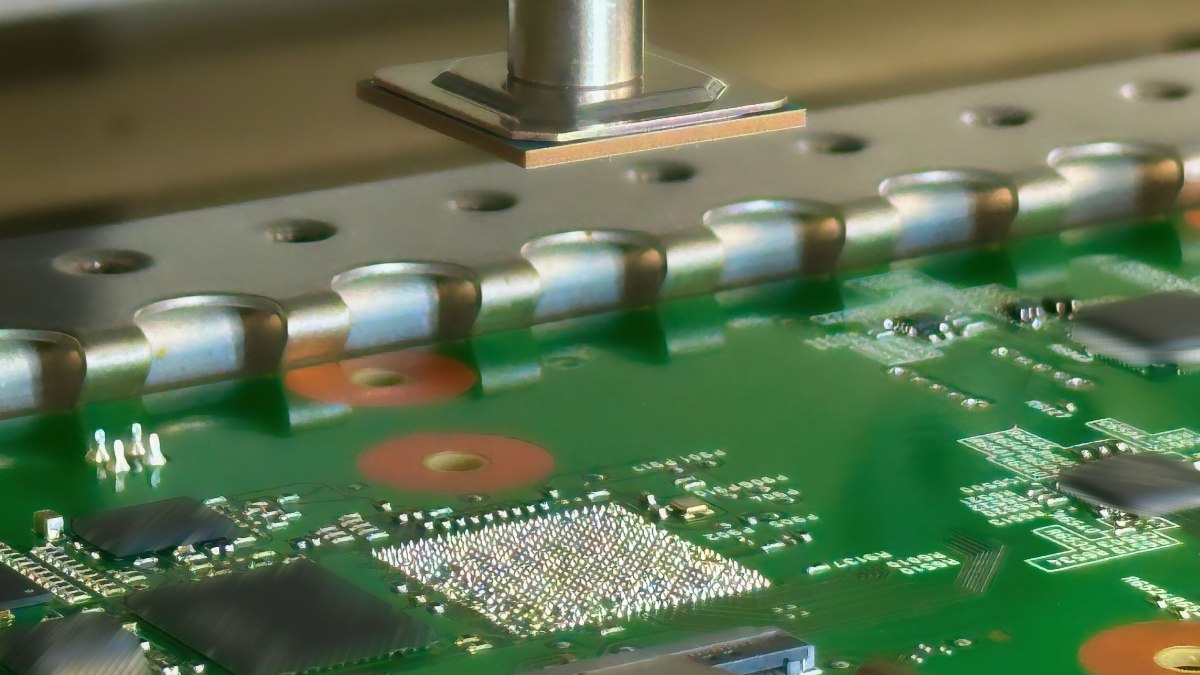
Troubleこんなお悩みありませんか?
BGAの不具合かはんだ不良か
切り分けできない
回路ミスで基板が動作しない
パターン修正やジャンパー線の
追加が必要になった
BGAのお困りごとはアイオン電子にお任せください!
Valueアイオン電子にできること
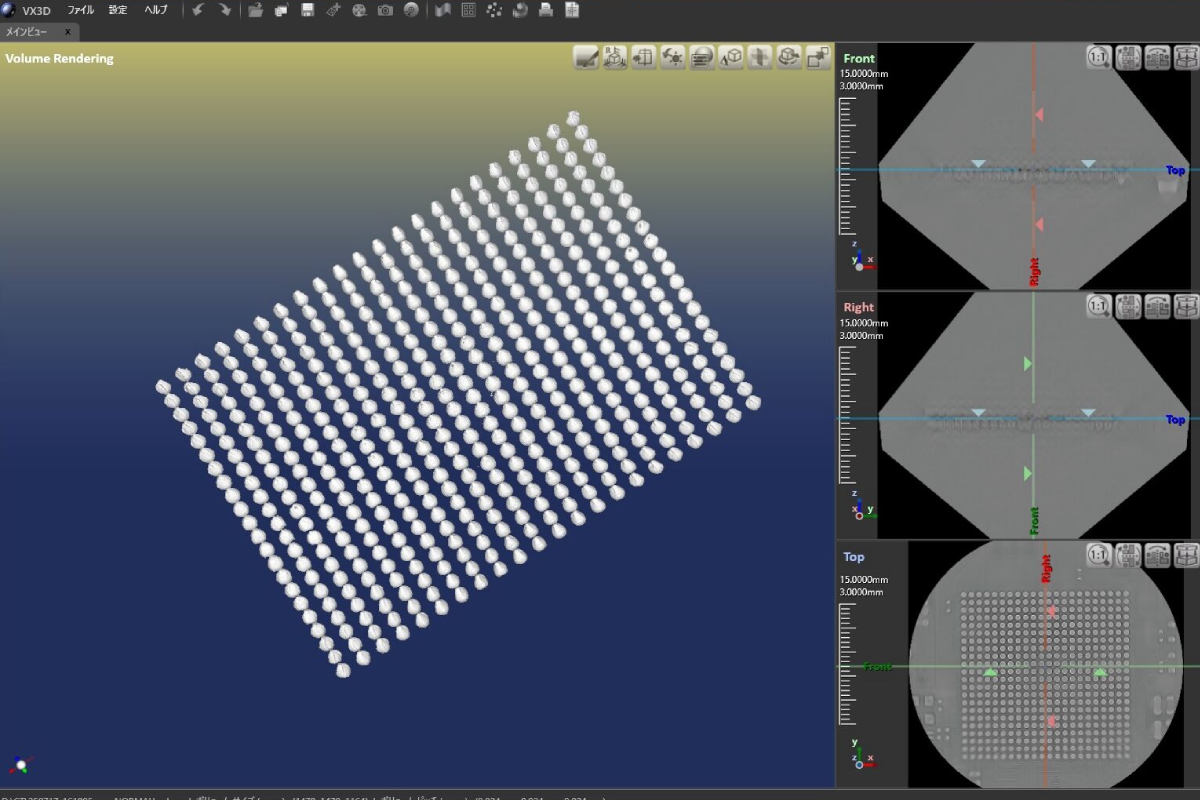
高精度な検査と修理
- X線による非破壊検査で、BGAの下の状態を確認
- はんだ付けの状態を詳細に分析し、不良箇所を特定
- 実装ミスの原因を特定し、適切な修理方法を提案
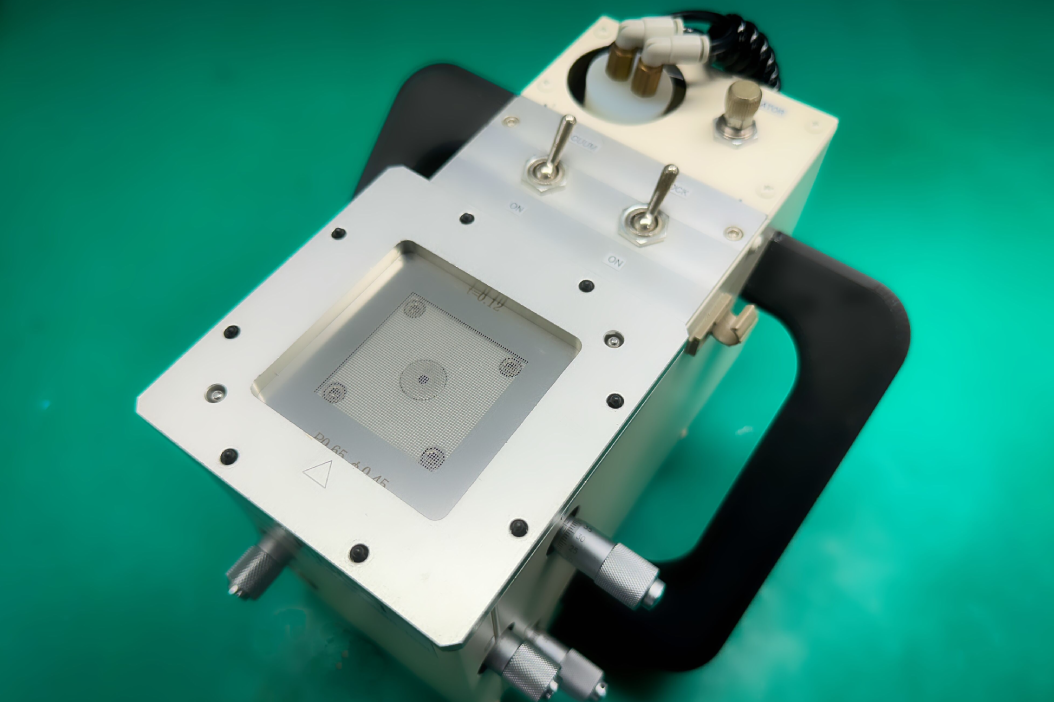
迅速な対応と豊富な実績
- 0402チップ、WL-CSPなど微小なサイズにも対応
- 大型・多層基板にも対応
- 1枚からの対応や特急の修理依頼にも対応
- 弊社メタルマスク在庫がある場合、イニシャル費削減が可能
リワークは、基板到着後から3営業日を目安に対応しております。
お急ぎの場合も対応可能ですのでご相談ください。
注)別途費用が掛かります。
FlowBGAリワークの流れ
事前確認・受け入れ検査
BGA取り外し
リワーク機を使い、基板からBGAを外します。
BGA部品単体の解析のためにBGAを取り外し、半導体メーカー様や半導体商社様へ送付した事例も多数あります。
BGA部品を取り外したのちに、基板のショートチェックや導通チェック、抵抗値の測定等の実施も可能です。
指示がある場合は、ジャンパー線反対側の接続をします。

BGA部品単体の解析のためにBGAを取り外し、半導体メーカー様や半導体商社様へ送付した事例も多数あります。
BGA部品を取り外したのちに、基板のショートチェックや導通チェック、抵抗値の測定等の実施も可能です。
指示がある場合は、ジャンパー線反対側の接続をします。

リボール作業
リボール機を使用し、BGAにボール搭載を行います。
解析用のリボールや部品のリユース、鉛フリーのはんだボールと共晶の交換も実施可能です。
部品の購入が難しい場合や納品まで時間がかかる、高額な部品を再利用されたい場合などのリボールのご相談もお受けしています。

解析用のリボールや部品のリユース、鉛フリーのはんだボールと共晶の交換も実施可能です。
部品の購入が難しい場合や納品まで時間がかかる、高額な部品を再利用されたい場合などのリボールのご相談もお受けしています。

BGA指定箇所(はんだボール)の
ジャンパー線接続作業 BGAのボール端子または基板側のランドからジャンパー線を引き出します。
1.27mmピッチから0.5mmピッチまで幅広いボール間ピッチに対応が可能です。
0.5mmピッチ以下の実績もありますので、ご相談ください。

ジャンパー線接続作業 BGAのボール端子または基板側のランドからジャンパー線を引き出します。
1.27mmピッチから0.5mmピッチまで幅広いボール間ピッチに対応が可能です。
0.5mmピッチ以下の実績もありますので、ご相談ください。

BGA再実装作業
リワーク機を使って基板へBGAを実装します(新品BGA部品/リボールしたBGA部品)。
POP実装やインターポーザ、ソケット等の実装も可能です。
BGA実装後には、X線検査、BGA周辺箇所および裏面箇所の目視検査を実施します。
BGA周辺部品への溶けや変色が発生する等の懸念事項やリスクがある場合は、事前にご連絡し相談の上実施いたします。

POP実装やインターポーザ、ソケット等の実装も可能です。
BGA実装後には、X線検査、BGA周辺箇所および裏面箇所の目視検査を実施します。
BGA周辺部品への溶けや変色が発生する等の懸念事項やリスクがある場合は、事前にご連絡し相談の上実施いたします。

X線検査
リワーク後の状態を観察、検査します。
検査データの提供も可能です。ご要望により、リワーク前のX線検査も可能です。
BGA部品の実装状態の確認や不具合個所(未はんだ、はんだブリッジ、異形、異物、ボイド等)の発見、撮影を行います。

検査データの提供も可能です。ご要望により、リワーク前のX線検査も可能です。
BGA部品の実装状態の確認や不具合個所(未はんだ、はんだブリッジ、異形、異物、ボイド等)の発見、撮影を行います。

梱包・出荷
お客様からお預かりした大切な部品を慎重かつ丁寧に取り扱い、梱包、出荷いたします。
BGAジャンパー接続が必要な場合の多くは、パターンカット(または指定箇所の基板との絶縁処理)がありますがBGA再実装作業の前で実施します。
基板との絶縁方法は、カプトンテープ貼り付けによる絶縁やレジスト液を塗布しての絶縁などがあります。
はんだボールピッチ0.5mm以上のBGAは対応が可能です。
その他、どのようなことでもまずは一度ご連絡ください。
お役に立てることがあると思います。
